Istnieje wiele metod służących do analizy powierzchni ciał stałych. Do najczęściej używanych zaliczyć możemy m.in. spektroskopię elektronów Augura (AES - Auger Electron Spectroscopy), spektroskopię fotoelektronów wzbudzanych promieniowaniem X (XPS - X-Ray Photoelectron Spectroscopy), spektrometrię mas jonów wtórnych (SIMS - Secondary Ion Mass Spectrometry), spektrometrię mas rozpylonych cząstek neutralnych (SNMS - Sputtered Neutral Mass Spectrometry), skaningową mikroskopię tunelową (STM - Scaning Tuneling Microscopy), mikroskopię sił atomowych (AFM - Atomic Force Microscopy).
Badania powierzchni ciała stałego dostarczają istotnych informacji na temat składu chemicznego, natury strukturalnej i zjawisk fizycznych zachodzących na powierzchni struktury. Dzięki zastosowaniu trawienia jonowego [1], metody analizy powierzchni mogą być wykorzystane do analizy profilowej [2-5].
Spektrometria mas jonów wtórnych jest metodą badania powierzchni ciał stałych umieszczanych w próżni, które poddaje się działaniu wiązki jonów pierwotnych. W wyniku wzajemnego oddziaływania jonów z atomami próbki następuje jej rozpylanie (rysunek 1). Występuje emisja elektronów, neutralnych atomów i grup atomów, dodatnich i ujemnych jonów zarówno atomowych, jak i utworzonych z grup atomów oraz fotonów. Metoda SIMS polega na zebraniu i analizie przez spektrometr mas jonów wtórnych niosących informacje o składzie analizowanego materiału.
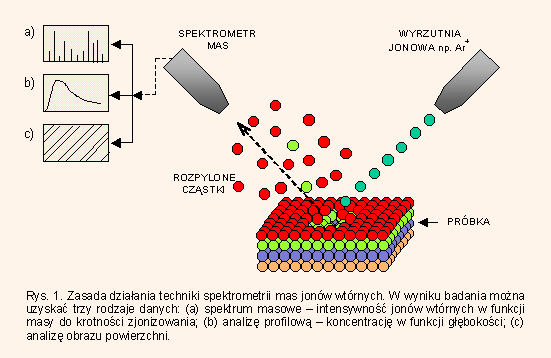
SIMS jest techniką "destrukcyjną" ze względu na rozpylanie próbki, stosowaną do wszystkich rodzajów próbek, które mogą być poddane działaniu ultra wysokiej próżni (izolatory, półprzewodniki, metale). Z tego względu wykluczone jest badanie np. powierzchni wody. Metoda ta umożliwia analizę zarówno molekularną, jak i elementarną pierwszej warstwy badanej struktury oraz zawartości pierwiastków śladowych w głębszych warstwach. W niektórych analizatorach możliwe jest również obrazowanie próbki z wysoką powierzchniową rozdzielczością (do 40 nm). Za pomocą metody SIMS możliwe jest wykrycie jonów złożonych z grupy atomów oraz rejestracja izotopów pierwiastków.
Istotną cechą spektrometrii SIMS jest fakt, że emisja jonów wtórnych następuje wyłącznie z pierwszych dwu monowarstw atomowych bombardowanej powierzchni [3], tak więc rejestrowany sygnał charakteryzuje skład powierzchni, a metoda ta jest powierzchniową metodą badania ciał stałych, znajdując szerokie zastosowanie w wielu dziedzinach nauki, wszelkiego rodzaju ilościowej i jakościowej analizie chemicznej. Metoda SIMS stosowana jest powszechnie do analizy profilowej płaskich układów warstwowych [2,5,15]. Ostatnio rozszerza się zakres badanych struktur, m.in. o trójwymiarowe struktury takie jak np. mikro- i nanocząstki pyłów zanieczyszczających środowisko oraz pyłów spawalniczych [16,17].
Podstawowymi zjawiskami fizycznymi wykorzystywanymi w analizie SIMS są: bombardowanie jonowe oraz związane z nim rozpylanie jonowe a także zjawisko jonizacji.
W celu wywołania zjawiska bombardowania jonowego w aparaturze SIMS stosuje się wyrzutnie jonów pierwotnych. Wyrzutnia składa się ze źródła jonów (stosuje się m.in. źródła plazmowe, z jonizacją powierzchniową oraz z bombardowaniem elektronowym), układu przyspieszającego i ogniskującego oraz z układu przemiatania wiązki. Do najczęściej stosowanych źródeł jonów pierwotnych zalicza się źródła jonów z jonizacją poprzez bombardowanie elektronami, których strumień emitowany z katody przyspieszany jest w kierunku anody. Strumień elektronów w wyniku kolizji ze znajdującymi się cząsteczkami w źródle w fazie gazowej prowadzi do jonizacji cząsteczek.
Oddziaływanie jonów z ciałem stałym rozpatrywać należy w odniesieniu do przypowierzchniowych warstw bombardowanego materiału o grubości równej w przybliżeniu głębokości wnikania jonów pierwotnych. Głębokość wnikania zależy od energii i rodzaju bombardujących jonów, a także od rodzaju bombardowanego materiału. Część jonów, które bombardują analizowany materiał, jest rozpraszana na atomach powierzchniowych powracając do fazy gazowej, a większa ich część wnika w głąb ciała stałego.
Metoda trawienia jonowego zastosowana w technice SIMS umożliwia wykonanie analizy profilowej, która polega na określeniu, jak zmienia się koncentracja poszczególnych składników w trakcie usuwania kolejnych warstw atomowych trawionej próbki. Wynik analizy profilowej uzyskuje się, kiedy spektrometr mas w czasie rozpylania próbki mierzy intensywność jonów wtórnych (dla wybranych składników), zbieranych z różnej głębokości analizowanej struktury. W tym celu powierzchnia próbki przemiatana jest wiązką jonową w systemie rastra z jednakową gęstością prądu na wybranym polu trawienia w celu uzyskania płaskiego dna krateru, równoległego do wyjściowej powierzchni.
Istnieje wiele sposobów przemiatania wiązką. Do najczęściej stosowanych zaliczamy przemiatanie "linia po linii" oraz "po spirali".
Procedura odchylania wiązki jonowej umożliwia przemiatanie próbki wiązką jonów pierwotnych po spirali wypełniającej kwadrat o zadanym polu. Przemiatanie po spirali ułatwia sterowanie licznikiem jonów wtórnych i obróbkę uzyskiwanych danych. Parametrami określającymi warunki sterowania są: ilość punktów na boku spirali, odległość pomiędzy punktami oraz czas zatrzymania się wiązki w jednym punkcie. Przyjmuje się zasadę, by każdy punkt trawiony był jednakowo długo oraz, by odstępy pomiędzy sąsiednimi punktami były jednakowe ze względu na konieczność stosowania jednakowej gęstości prądu wiązki jonowej na wybranym polu trawienia.
Precyzja pomiaru w analizie profilowej łączy się z umiejętnością dokładnego określenia głębokości z, na której znajduje się dana granica międzyfazowa w badanym układzie warstwowym. Błąd pomiaru tej głębokości opisany jest poprzez głębokościową zdolność rozdzielczą Δz [5].
Głębokościową zdolność rozdzielczą analizy profilowej, mierzoną w trakcie przekraczania granicy dwóch materiałów, możemy opisać podając zakres głębokości trawienia z, odpowiadający wzrostowi (spadkowi) wartości intensywności mierzonego pierwiastka z ok. 16% do ok. 84% (84%-16%) jego maksymalnej wartości.
Dokładność, z jaką wyznacza się Δz, zależy od gęstości punktów pomiarowych (różnicy głębokości pomiędzy kolejnymi pomiarami).
Zakładając, że na granicy dwóch warstw następuje skokowa zmiana koncentracji jakiegoś pierwiastka, to rozkład koncentracji charakteryzuje wykres a (rysunek 4). Rzeczywisty pomiar koncentracji pierwiastka odbiega jednak od rozkładu z wykresu a i może wyglądać jak na wykresie b. Wynika to z niedokładności pomiaru i spowodowane jest wieloma czynnikami.
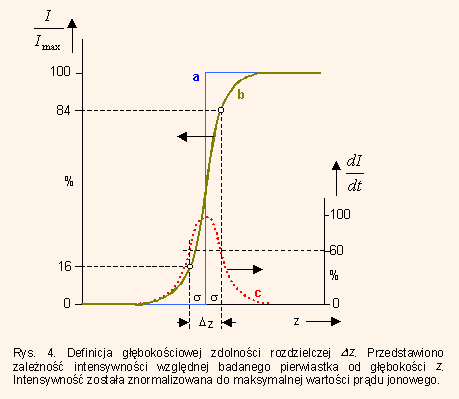
W definicji Δz zakłada się, że krzywą koncentracji uzyskaną w rzeczywistym pomiarze daje się opisać, z dobrym przybliżeniem całką z funkcji Gaussa, a więc błąd popełniony przy pomiarze będzie miał kształt pochodnej funkcji opisującej wykres b, czyli będzie miał kształt funkcji Gaussa (krzywa c). Głębokościowa zdolność rozdzielcza odpowiada, co do wartości, dwóm odchyleniom standardowym σ [24], czyli zakresowi głębokości trawienia odpowiadającemu zmianie wartości intensywności mierzonego pierwiastka z ok. 16% do ok. 84% maksymalnej wartości.
Osiągnięcie nieskończenie wysokiej zdolności rozdzielczej (Δz→0) ograniczone jest czynnikami wpływającymi na dokładność pomiaru w czasie trawienia jonowego.
Na wartość zmierzonej wielkości Δz, przy określeniu rzeczywistego rozkładu koncentracji, ma wpływ wiele czynników, m.in.:
- Δzo - szerokość przejścia międzyfazowego;
- Δzs - chropowacenie powierzchni wynikające ze statystyki rozpylania jonowego;
- Δzk - mieszanie atomów;
- Δzλ - głębokość informacji;
- Δzr - zmiany topografii powierzchni w czasie rozpylania jonowego;
- Δzw - niejednorodność wiązki jonowej;
- i inne.
Δz = √∑(Δzi)2,
gdzie: i = o, s, k, λ, r, w,... .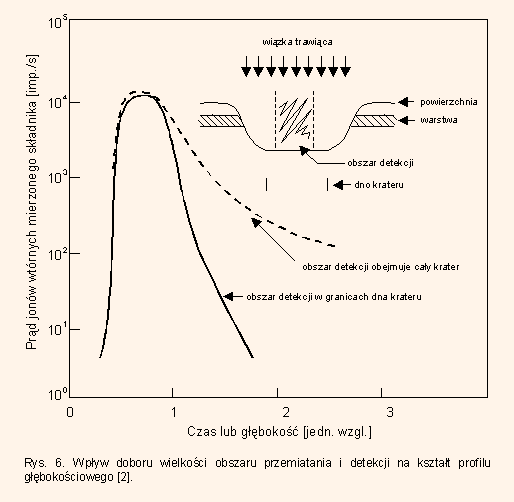
Przy wyborze wielkości pola przemiatania należy mieć na uwadze, że większe pole trawienia pociąga za sobą mniejszą gęstość prądu, a w rezultacie mniejszą szybkość trawienia w czasie analizy profilowej.
Pomiar w metodzie spektrometrii mas jonów wtórnych sprowadza się do wyznaczenia rozkładu gęstości prawdopodobieństwa (widma) masy w promieniowaniu wtórnym. Dokonuje się tego za pomocą różnego typu analizatorów i detektorów. Większość jonów wtórnych powstaje w wyniku utraty przez atomy jednego elektronu, jednak w widmie mogą występować jony wielokrotnie naładowane. Identyfikacja emitowanych jonów może następować poprzez pomiar ich mas w spektrometrze masowym, a rejestracja jonów w spektrometrach odbywa się w zależności od stosunku masy jonu do krotności jego zjonizowania (m/e). Pomiar mas jonów dostarcza informacji na temat składu pierwiastkowego powierzchni, a także natury i struktury cząsteczek chemicznych, z których powstały w wyniku rozpylania.
Ze wszystkich emitowanych cząstek jony stanowią niewielką część, średnio procenty, lub ułamki procentów. Wystarcza to jednak do uzyskania niezbędnych informacji o składzie analizowanego materiału, a metoda SIMS uważana jest za najbardziej czułą spośród metod analizy powierzchni. Natężenie prądu wybranych jonów wtórnych Ix dla składnika x, mierzone w torze detekcji mas można określić następującą zależnością:
Ix = I0 · S± · Ω · τ · Cx,
gdzie: I0 - prąd jonów pierwotnych, S± - wydajność wtórnej emisji jonowej, Ω - bryłowy kąt detekcji, τ - współczynnik transmisji układu detekcji (stosunek liczby cząstek rejestrowanych do liczby cząstek docierających do układu detekcji), Cx -koncentracja składnika x.Aby wnioskować o koncentracji C, konieczna jest znajomość pozostałych składników, a w szczególności S±. Skomplikowana zależność S± od składu otaczających atomów, wynikająca z efektów matrycy uniemożliwia w praktyce określenie tej wielkości, a zatem pomiar bezwzględny nie jest możliwy. Z tego też względu najczęściej stosowanym sposobem pomiaru ilościowego jest porównanie sygnału z próbki mierzonej z sygnałem z próbki wzorcowej o znanym składzie atomowym.
Do najczęściej stosowanych analizatorów mas w urządzeniach SIMS zalicza się kwadrupolowe filtry mas [37]. Ostatnio często także w urządzeniach tego typu stosuje się układ detekcji związany z czasem przelotu produktów rozpylania, tzw. spektrometr "Time of flight" [38]. Innym typem spektrometru jest spektrometr magnetyczny [39], gdzie segregację jonów uzyskuje się przez odchylenie wiązki jonów w obszarze jednorodnego pola magnetycznego lub w obszarze wzajemnie się przenikających i prostopadłych do siebie pól: elektrycznego i magnetycznego.
Przykładowa aparatura SIMS (typ SAJW-05) jest na wyposażeniu Pionu Technologii Próżniowej w Przemysłowym Instytucie Elektroniki w Warszawie, której widok ogólny przedstawia rysunek 9. Konstrukcja aparatury umożliwia analizę powierzchni oraz analizę profilową ciał stałych metodą spektrometrii mas jonów wtórnych. Na stanowisko pomiarowe składa się aparatura próżniowa oraz blok urządzeń elektronicznych, zasilających, sterujących i rejestrujących wyniki pomiarowe. Aparaturę próżniową stanowi komora próżniowa wyposażona w zestaw pomp do wytwarzania wysokiej i bardzo wysokiej próżni. W komorze umieszczone są wyrzutnia jonowa Physical Electronics 06-350E (zakres energii 150-5000 eV) wytwarzająca wiązkę jonów Ar+ skierowaną pod kątem 45° do poziomo usytuowanych powierzchni badanych próbek, kwadrupolowy spektrometr mas Balzers QMA-410 (zakres analizowanych mas: 0-300 j.m.a.) także skierowany do podłoża pod kątem 45° oraz układ precyzyjnych manipulatorów z uchwytem próbek, umożliwiających pozycjonowanie, a także ciągły obrót próbek w trakcie prowadzenia analizy profilowej.
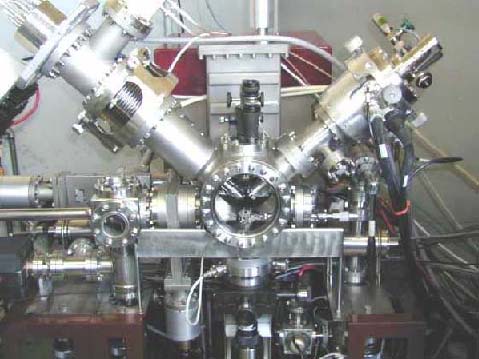
Rys. 9 Widok ogólny spektrometrycznego analizatora mas jonów wtórnych SAJW-05.
Specjalny wziernik optyczny umożliwia obserwowanie powierzchni bombardowanej próbki poprzez mikroskop optyczny umieszczony na zewnątrz komory próżniowej. Wymiana próbek odbywa się dzięki zastosowaniu trójstopniowego układu śluzowego wyposażonego w dwa zawory szybrowe oraz magnetyczne układy transportowe. Kontrolę odpowiednich warunków przebiegu procesu pomiarowego sprawują dodatkowo: działo elektronowe, głowice sond próżniowych oraz odpowiednie wzierniki.
Dodatkowe wyposażenie stanowi profilometr igłowy Tencor Alpha step 100 przeznaczony do analizy kształtu wytrawionych kraterów w badanych próbkach.
Układ pompowy stanowiska SAJW-05 ma za zadanie zapewnienie ultra-wysokiej próżni wolnej od węglowodorów w komorze pomiarowej. Do tego celu służą odpowiednio zestawione pompy bezolejowe połączone złączami próżniowymi. System odpompowania połączonych śluz wyposażonych w pompę turbomolekularną (60 dm3/s) oraz w pompę jonowo-sorpcyjną PZK-20 pozwala na transport próbki od atmosfery do obszarów wysokiej próżni. Ultra-wysoka próżnia w komorze pomiarowej wytwarzana i utrzymywana jest poprzez układ pompowy PJ-400 wyposażony w pompę jonowo-sorpcyjną, układ sublimatorów tytanowych wraz z płaszczem chłodzonym wodą lub ciekłym azotem oraz zestaw geterów typu NEG. Uzyskiwana próżnia końcowa w układzie aparatury SAJW-05 wynosi ok. 8·10-11 hPa.
Poniżej zaprezentowano wybrane wyniki analiz profilowych różnorodnych płaskich warstwowych układów niskowymiarowych a także mikro- i nanocząstek charakteryzujących się złożoną morfologią i różnorodnością składu wierzchnich warst i rdzenia. Przedstawione analizy wykonano na aparaturze SIMS typ: SAJW-05 w Przemysłowym Instytucie Elektroniki.
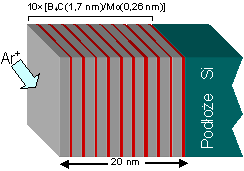 |
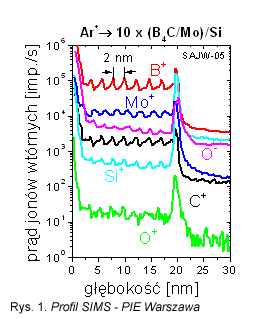 |
Rys. 1. Analiza profilowa układu warstwowego otrzymanego metodą CVD w RAN w Nizhnym Novgorodzie. Schemat struktury przedstawiono powyżej. Stosowano trawienie jonowe wiązką jonów Ar+ o energii 880 eV.
P. Konarski, A. Mierzejewska: Applied Surface Science 203-204 354-358 (2003)
 |
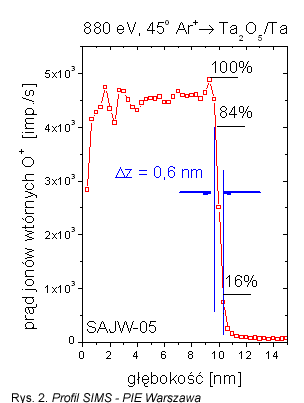 |
Rys. 2. Analiza profilowa warstwy tlenku tytanu na podłożu tytanowym. Schemat struktury przedstawiono powyżej. Zastosowano trawienie jonowe wiązką o energii 880 eV. Uzyskana głębokościowa zdolność rozdzielcza wynosi 0.6 nm.
P. Konarski, A. Mierzejewska: Applied Surface Science 203-204 354-358 (2003)
 |
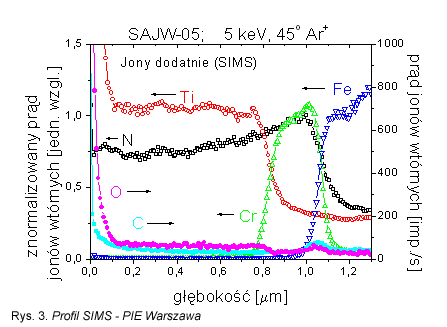 |
Rys. 3. Analiza profilowa TiN/CrN/Fe, struktury otrzymanej metodą naparowania łukowego na Wydziale Fizyki Uniwersytetu Białoruskiego w Mińsku. Zastosowano bombardowanie jonowe wiązką o energii 5 keV. Schemat układu przedstawiono powyżej.
V.M. Anischik , V.V. Uglov, S.V. Zlotski, P. Konarski, M. Ćwil, V.A. Ukhov: Vacuum (2005) (in press).
 |
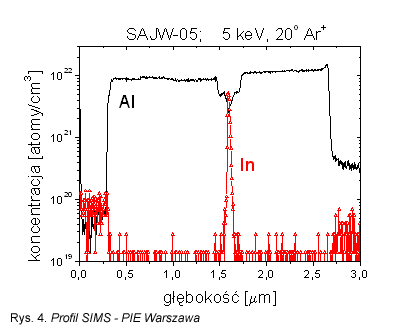 |
Rys. 4. Analiza profilowa struktury lasera półprzewodnikowego otrzymanego metodą MBE w Instytucie Technologii Elektronowej w Warszawie. Zastosowano trawienie jonowe wiązką o energii 5 keV skierowaną pod kątem 20 stopni do powierzchni próbki. Przedstwiono profile dwóch składników: Al oraz In. Schemat struktury zaprezentowano powyżej.
M. Ćwil, P. Konarski: Vacuum (in press) (2005)
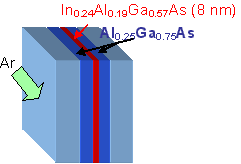 |
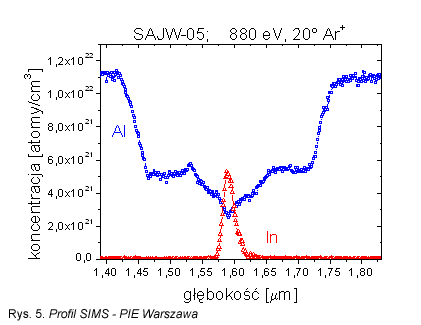 |
Rys. 5. Analiza profilowa studni kwantowej w strukturze lasera półprzewodnikowego, zaprezentowanego na rys. 4. Zastosowano trawienie jonowe wiązką o energii 880 eV skierowaną pod kątem 20 stopni do powierzchni struktury.
M. Ćwil, P. Konarski: Vacuum (in press) (2005)
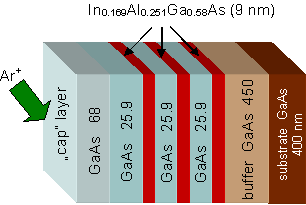 |
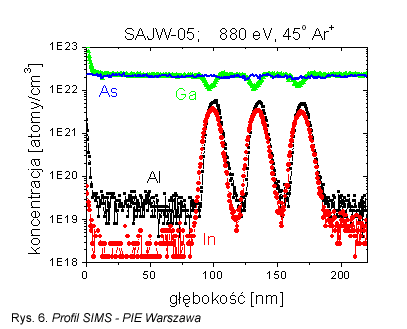 |
Rys. 6. Analiza profilowa struktury otrzymanej metodą MOVPE na Wydziale Elektroniki Mikrosystemów i Fotoniki Politechniki Wrocławskiej. Zastosowano trawienie jonowe wiązką o energii 880 eV. Schemat struktury przedstawiono powyżej.
P. Konarski, M. Ćwil, M. Zaremba, D. Radziewicz, B. Ściana, J. Kozłowski: Reviews on Advanced Materials Science 8 34-40 (2004).
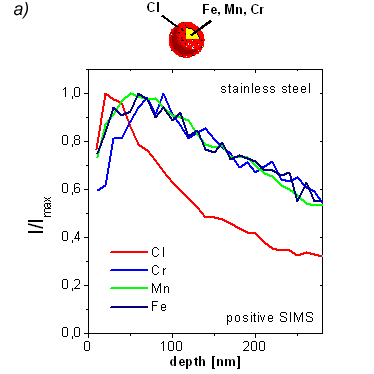 |
 |
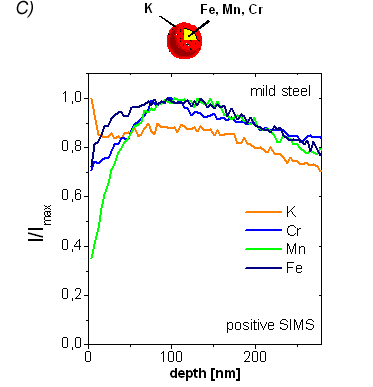 |
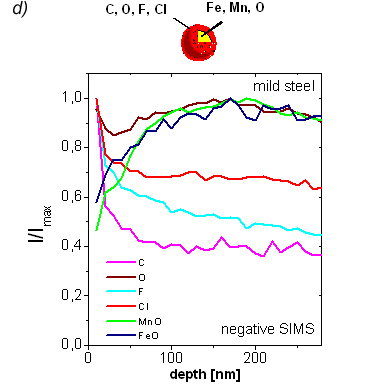 |
Rys. 7 a-d. Analizy profilowe pyłu spawalniczego. Przedstwoiono profile wybranych dodatnich a,c) oraz ujemnych b,d) jonów wtórnych będących składnikami badanego pyłu. Zastosowano trawienie jonowe wiązką o energii ..
P. Konarski, I. Iwanejko, M. Ćwil: Vacuum 70 385-389 (2003)
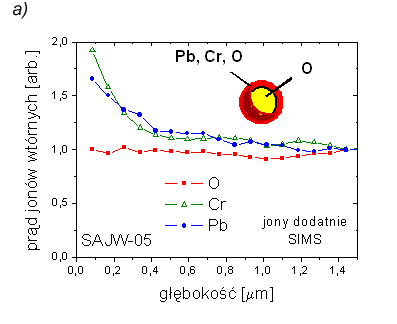 |
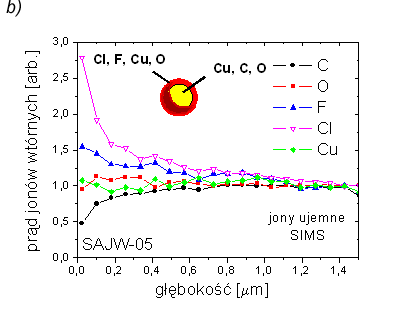 |
Rys. 8 a,b. Analiza profilowa pyłu sedymentacyjnego. Przedstawiono profile wybranych dodatnich a) oraz ujemnych b) jonów wtórnych będących składnikami badanego pyłu. Zastosowano trawienie jonowe wiązką o energii 2 keV
P. Konarski, M. Ćwil, I. Iwanejko, A. Mierzejewska, R. Diduszko: Thin Solid Films 459 86-89 (2004)
M. Ćwil: "Analiza profilowa heterostruktur wastwowych metodą spektrometrii mas jonów wtórnych", Praca dyplomowa, Politechnika Warszawska, Wydział Fizyki (2003).
(Kopiowanie tekstu i rysunków tylko z podaniem żródła i literatury!)
Literatura:
[1] O. Auciello and R. Kelly (eds.), Ion Bombardment Modification of Surfaces: Fundamentals and Applications. Elsevier, Amsterdam (1984)
[2] R.G. Wilson, F.A. Stevie, Ch.W. Magee, Secondary Ion Mass Spectrometry - A Practical Handbook for Depth Profiling and Bulk Impurity Analysis, John Wiley & Sons Inc., New York (1989)
[3] J.M. Walls, Methods of surface analysis: Techniques and Applications (1989)
[4] E.H. Cirlin, J. Vajo, T.C. Hasenberg, R.J. Hauenstein, "High resolution secondary ion mass spectrometry depth profiling using continuos sample rotation and its application to superlattice and delta doped sample analysis", J. Vac. Sci. Technol. A8, 4101 (1990)
[5] S. Hofmann, "Compositional depth profiling by sputtering", Prog. Surf. Sci. 36, 35 (1991)
[6] Z.L. Liau, B.Y. Tsaur, J.W. Mayer, "Influence of atomic mixing and preferential sputtering on depth profiles and interfaces", J. Vac. Sci. Technol. 16, 121 (1979)
[7] U. Littmark, W.O. Hofer, "Recoil mixing in solids by energetic ion beams", Nucl. Instrum. Methods 168, 329 (1980)
[8] G.H. Kinchin and R.S. Pease, Rep. Prog. Phys. 18, 1 (1955)
[9] P. Sigmund, Appl. Phys. Lett. 14, 114 (1969)
[10] H.H. Andersen, "The Depth Resolution of Sputter Profiling", Appl. Phys. 18, 131 (1979)
[11] I. Koponen, M. Hautala, "High energy ion beam mixing in dense collision cascades", Nucl. Instr. Meth. B69, 182 (1992)
[15] P. Konarski, A. Mierzejewska, "B4C/Mo/Si and Ta2O5/Ta nanostructures analysed by ultra-low energy argon ion beams", Appl. Surf. Sci. 203-204, 354 (2003)
[16] P. Konarski, I. Iwanejko, A. Mierzejewska, M. Ćwil, "Analiza profilowa mikro- i nanocząstek pyłów i dymów spawalniczych", Elektronika 12, 42 (2002)
[17] P. Konarski, I. Iwanejko, M. Ćwil, "Core-shell morphology of welding fume micro- and nanoparticles", Vacuum 70, 385 (2003)
[18] H.H. Andersen and H.E. Bay, Radiat. Effects 19, 257 (1973)
[19] P. Sigmund, Phys. Rev. 184, 383 (1969)
[20] P. Sigmund, Red. Effects 11, 39 (1971)
[21] R. Behrish, "Sputtering by ion bombardment", Berlin, Spring Verlag (1981)
[22] A.W. Czanderna (red.), Methods of surface analysis, Amsterdam, Elsevier Publ. Comp., (1975)
[23] A. Benninghoven, Surface Science 53, 596 (1973)
[24] C.W Magee, R.E. Honig, Surface and Interface Analysis 4, 35 (1982)
[25] E. Fuchs, H. Oppolzer, H. Rehme, Particle Beam Microanalysis. Fundamentals, Methods and Applications, VCH, Weinheim (1990)
[26] J.B. Clegg, R.B. Beal, Surf. Interf. Anal. 14, 307 (1989)
[27] M.G. Dowsett, "Depth profiling using ultra-low-energy secondary ion mass spectrometry", Appl. Surf. Sci. 203-204, 5 (2003)
[28] F. Horreard, III Polish - French Symposium on Vacuum Science, Technology and Applications, Elektronika 11, 7 (2000)
[29] T.M. Mayer, E. Chason, A.J. Howard, "Roughening instability and ion-induced viscous relaxation of SiO2 surfaces", J. Appl. Phys. 76, 1633 (1994)
[30] J. Erlewein, S. Hofmann, "A model calculation of the influence of surface transport on the depth resolution in sputter profiling", Thin Solid Films L39, 69 (1980)
[31] M.P. Seah, J.M. Sanz, S. Hofmann, "The statistical sputtering contribution to resolution in concentration-depth profiles", Thin Solid Films 81, 239 (1981)
[32] P. Konarski, "Rzeźba jonowa w analizie profilowej SIMS półprzewodnikowych heterostruktur warstwowych". Praca doktorska, ITE Warszawa, (1996)
[33] E.A. Eklund, R. Bruinsma, J. Rudnick, R.S. Wiliams, "Submicron-Scale Surface Roughening Induced by Ion Bombardment", Phys. Rev. Lett. 67, 1759 (1991)
[34] J. Krim, I. Heyvaert, C. Van Heasendonck and Y. Bruynseraede, "Scanning Tunneling Microscopy Observation of Self-Affine Fractal Roughness in Ion-Bombarded Film Surfaces", Phys. Rev. Lett. 70, 57 (1993)
[35] R.M. Bradley, J.M.E. Harper, "Theory of ripple topography induced by ion bombardmen`t", J. Vac. Sci. Technol. A6, 2390 (1988)
[36] W.O. Hofer, H. Liebl, G. Roos and G. Staundenmaier, J. Mass Spectrosc. Ion Phys. 19, 327 (1976)
[37] P.H. Dawson, N.R. Whetten, "Quadrupoles, monopoles and ion traps", Res/Dev. 19, 46 (1969)
[38] G.H. Oetjen and W.P. Poschenrieder, Int. J. Mass Spectrom. Ion Phys. 16, 353 (1975)
[39] R. Castaing and G. Slodzian, J.Phys. E14, 1119 (1981)
[40] J.F. Ziegler, J.P. Biersack, U. Littmark, SRIM-98, IBM Research, Yorktown, NY (1998)